一、EUV掩模:芯片制造的“光学模板”
与传统透射式光掩模不同,EUV掩模采用反射式设计(因EUV光易被材料吸收)。其表面吸收层的高度变化需精确控制,才能实现13.5nm极紫外光的精准反射与衍射。
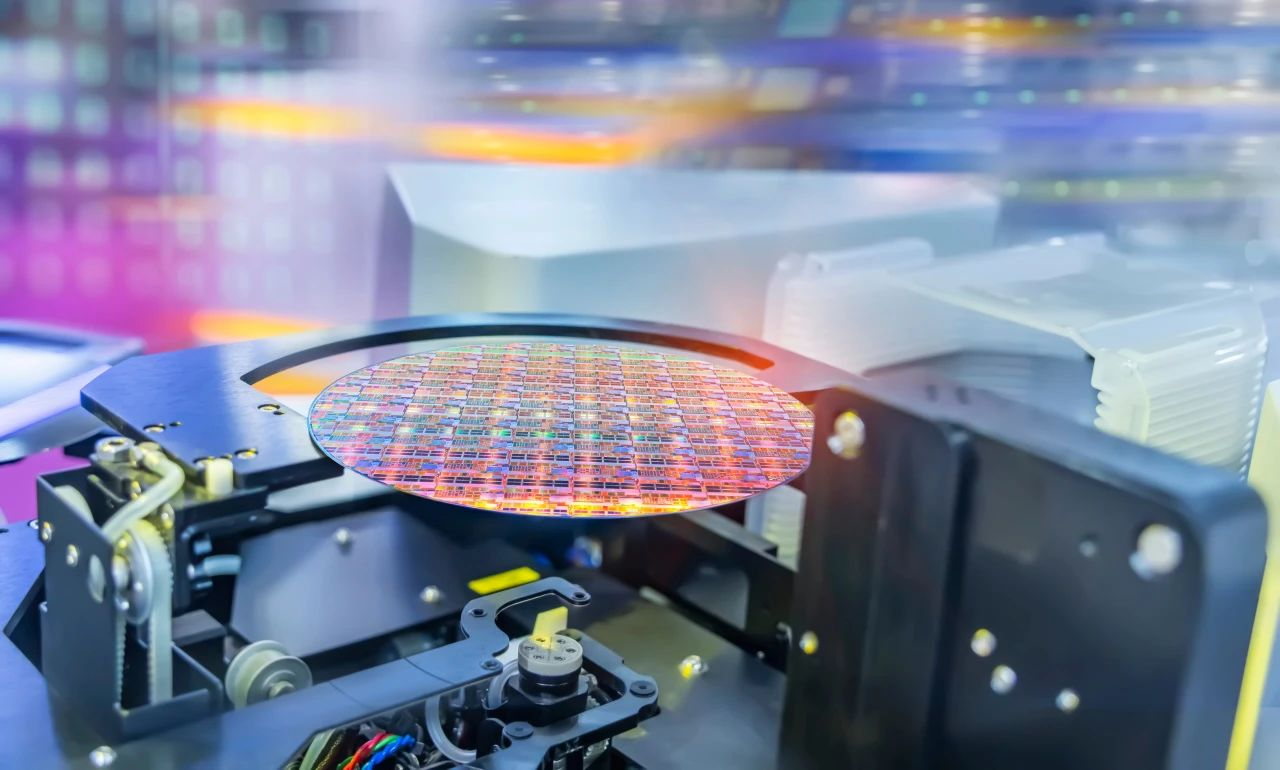
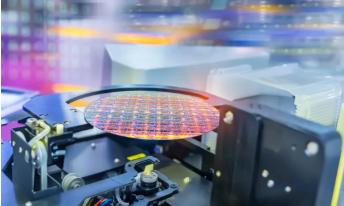
关键挑战:
•吸收层台阶高度误差需<1nm
•多层膜表面粗糙度要求<0.2nm
二、S neox测量系统:亚纳米精度的三大突破
1. 白光干涉技术
通过分析反射光干涉条纹的相位变化,实现三维形貌纳米级重建,可精准捕捉吸收层微结构:


2. 0.01nm纵向分辨率
相当于1个硅原子直径的1/20,能检测到肉眼不可见的膜层凸起或凹陷:
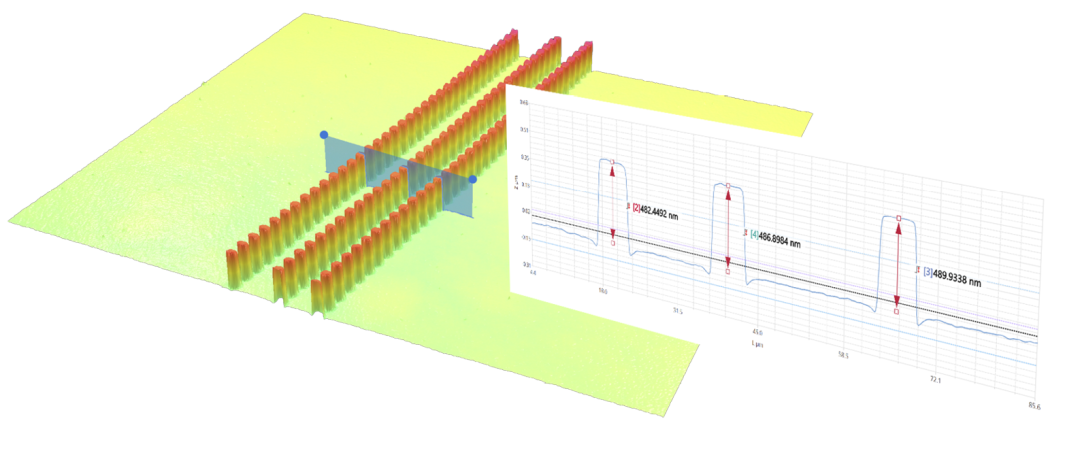
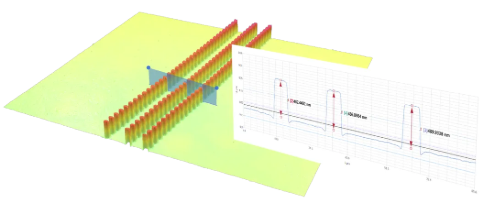
3. 高效动态扫描
•单视野扫描仅需2秒(50倍物镜)
•自适应光学系统实时优化光路,应对表面倾斜或反射率变化:



三、从实验室到量产:测量技术如何赋能制造?
▶ 缺陷检测
识别吸收层残留物、多层膜剥落等致命缺陷,避免数千万美元的晶圆报废:


▶ 工艺优化
量化刻蚀与沉积工艺的均匀性,推动良率提升:


四、结语
随着3nm以下制程的演进,EUV掩模的测量精度需求将持续攀升。Sensofar S neox为代表的测量技术,正在为摩尔定律的延续铺设“看不见的基石”。
版权所有:北京仪光科技有限公司 备案号:京ICP备2021017793号